����Ԫ���Ĺ�����������IGBT�Ĺ������MOSFET�ĶԱ���ͼ��ʾ��IGBT��ͨ���ڹ���MOSFET��©������p+������ɵģ��Ӷ�������������������
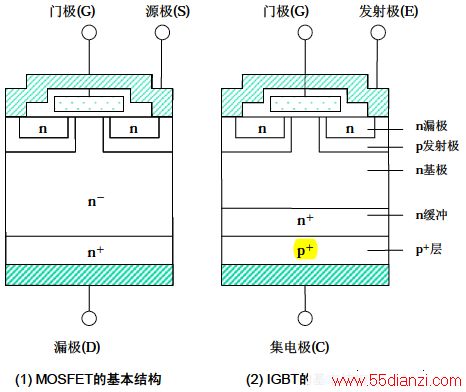
����������֪������MOSFET��ͨ�����ż����������ѹ��ʹp�������γɹ������Ӷ����뵼ͨ״̬�ġ���ʱ������n���伫��Դ�������n�������Թ���Ϊý�����ͨ��MOSFET��©��—Դ��֮���γ��˵�һ�İ뵼�壨��ͼ1-1�е�n�ͣ������ĵ�����Ҳ�ͳ��˵����ĵ��衣�õ���Խ�ͣ�̬ͨ��ѹҲ�ͱ��Խ�͡����ǣ���MOSFET������ѹ����ͬʱ��n��������Ҫ�Ӻ�n������������������״̬�£�ά��©��—Դ��֮������ӵĵ�ѹ����ˣ���Ҫά�ֵĵ�ѹԽ�ߣ��ò��Խ��Ԫ������ѹ����Խ�ߣ�©��—Դ��֮��ĵ���Ҳ�����ӡ�����Ϊ��ˣ�����ѹ�Ĺ���MOSFET��̬ͨ��������ʹ�����ĵ���˳��ͨ�������ʵ�ִ��������dz����ѡ�
���������һ�㣬IGBT����������p+�㣬���Դ�©����������������n������֮�乹����pn�����ܡ���Ϊ��������ܵ����ã�n�����õ��絼�ʵ��ƣ��Ӷ�ʹ̬ͨ�����С���������Ժ��Ե�ֵ����ˣ�IGBT��MOSFET��ȣ��ܸ�����ʵ�ִ���������
��������ĵ�Ч��·��IGBT��PNP˫���;���ܺ���MOSFET���д��ֶ����Ӻ��γɵĵ�Ƭ������Bi-MOS����ܡ����⣬IGBT��˫���;���ܵ�оƬ����MOSFET��оƬ��ͬ��ϳɵĻ�ϼ�����Bi-MOS����ܵ���������ڹ���MOSFET����̬ͨ���衣��IGBT�й���MOSFET����̬ͨ��������С���ٿ��ǵ�оƬ����Ҫ������һ�㣬IGBT�Ȼ�ϼ�����Bi-MOS�������Խ��
����1����ѹ������Ԫ��
����IGBT�������Ч��·������ͼ��ʾ���Ƕ�pnp˫���;���ܺ���MOSFET���д��ֶ����Ӻ��γɵĵ�Ƭ��Bi-MOS����ܡ�
������ˣ����ż�—���伫֮���������ѹʹ����MOSFET��ͨʱ��pnp����ܵĻ���—���缫����������˵͵��裬�Ӷ�ʹpnp����ܴ��ڵ�ͨ״̬��
�����˺�ʹ�ż�—���伫֮��ĵ�ѹΪ0Vʱ�����ȹ���MOSFET���ڶ�·״̬��pnp����ܵĻ����������жϣ��Ӷ����ڶ�·״̬��
��������������IGBT����MOSFETһ����ͨ����ѹ�źſ��Կ��ƿ�ͨ�ض϶�����

����2����ѹ��������
����IGBT����MOSFETͬ������Ȼ���ż����������ѹ���ɵ�ͨ����������ͨ����©������p+�㣬�ڵ�ͨ״̬�´�p+����n����ע���Ѩ���Ӷ������������ܵ�ת�䣬������빦��MOSFET��ȣ����Եõ����͵�̬ͨ���衣
������ IGBTģ�������
����������6MBI100UB-120��1200V/100AԪ���������IGBTģ�飩Ϊ������˵����ȼ��صĹ���IGBT���������Խ���˵����
����1����̬����
������Uϵ�е�IGBT��6MBI100UB-120Ϊ������ͼ1��ͼ2��ʾVCE-IC��һ���Ϊ������ԣ���VGE�����ԡ���Ϊ�����Ա�ʾIGBT�ڵ�ͨ״̬���½���ѹ��VCE���͵�����IC����Ĺ�ϵ�������γ����ڵ�ͨ״̬��IGBT�з�������ġ�Ȼ������ȻVCEԽ�ͣ����������ԽС���������ڸ������Ǹ����¶ȣ�Tj����VGE�ı仯����֮�仯�ģ���ˣ����ڳ�ֿ��Ǹ����Ե�ǰ���½���װ�õ���ơ�
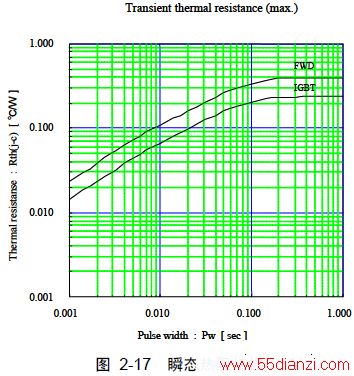 ����һ��������Ƽ���VGE=15V��װ���з����������������QԪ����IC�����ֵ�������ʹ�á����ߣ�ͼ3�ǽ�ͼ1�е�����ת����VCE-VGE���Ե�IC�����Ե�����ͼ�����Դ��п���VCE����ģ��������ӵ�����ʱVGE�Ĵ����ֵ��
����һ��������Ƽ���VGE=15V��װ���з����������������QԪ����IC�����ֵ�������ʹ�á����ߣ�ͼ3�ǽ�ͼ1�е�����ת����VCE-VGE���Ե�IC�����Ե�����ͼ�����Դ��п���VCE����ģ��������ӵ�����ʱVGE�Ĵ����ֵ��

����2����������
��������IGBTһ�����������õ���;����˳�����ͨ�ض�ʱ�Ľ������Էdz���Ҫ�����⣬���ڸ���������ֲ������仯�����Ҳ�б�Ҫ�ڿ��Ǹ����Ե�ǰ���½���װ�õ���ơ��ý������Կ��Դ��·�Ϊ����ʱ��ͽ�����������档
�������ȣ�ͼ5����2����̬������Ŀ���Խ���ʱ������˶��塣��ton��tr��tr��i����toff��tf��trr��Irr�߸���Ŀ�������Կ���ͨ��ͼ4��ʾ��ն����·�ⶨ��
����ͼ6��ͼ7��ͼ16��ʾ�˽���ʱ��ͼ��缫�����Ĺ�ϵ��ͼ8��ʾ�˽���ʱ����ż�����Ĺ�ϵ�����������Ľ���ʱ���漯�缫�������¶ȣ�Tj�����ż�����RG�ı仯���仯�����װ�õ�ʱ��ϣ������ֿ��ǡ�����˵���ڽ���ʱ�䣨�ر���toff���䳤��������RG�ϴ�ȣ���ʹ�ã����ܳ������ڿ���ʱ�䲻�����������֧·��·��������һͷ��IGBT�ض�ǰ����һͷ��IGBT�Ѿ���ͨ���Ӷ���������ĵ����IJ�����������Ȳ���������Ӷ�����Ԫ����ƻ������⣬Ҳ������tr���̵������£�����RG��С��ԭ��ʹ�õĻ����෴��˲̬�ĵ����仯��DIC/dt��������ڵ�·�еĵ�У�Ls���������ļ���ѹ��=Ls×dIc/dt��������RBSOA��Χ������Ԫ����ƻ�����Ҫ���ע�⡣
������һ���棬������ģ�Eon��Eoff��Err������IGBT����ʱ����ͨ���ض�ʱ�������ġ�����������ͼ9��ͼ10��ʾ���¶ȣ�Tj����IC��RG���仯�������ر��Ƕ�RG��ѡ���dz���Ҫ�����������������ı������������ǰ�����������ڿ���ʱ�䲻��������Ĵ���֧·��·��
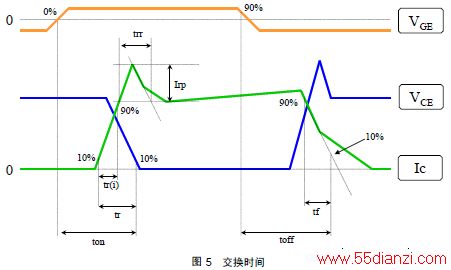
������֮����Ϊ��ʹ������Ľ�����Ͷ���RG��Сʱ���п��ܳ���ǰ�������ļ��ҵļ���ѹ��=Ls×dIc/dt�������⡣�������������ѡ��RG������·�ĵ�У�Ls���dz���Ҫ�����ڸ���ֵԽ�ͣ�����ѡ��RG��̽�־ͱ��Խ���ף���ʹRGС������ѹҲ�����׳��֣�������Ƽ���Ҿ�����Ls��ֵ��Ƶ�СһЩ��

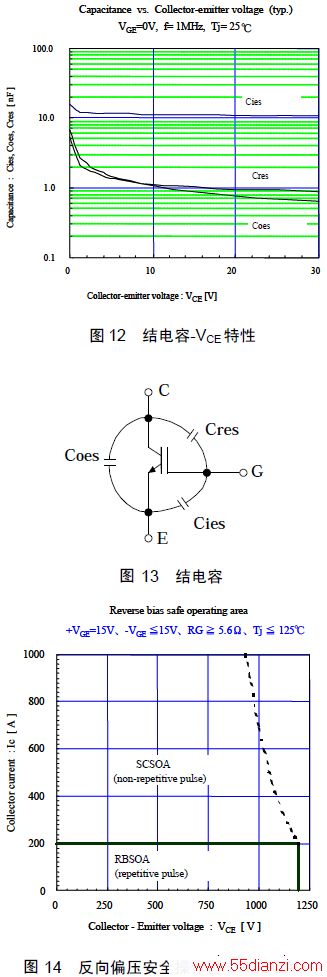 ����3����������
����3����������
����ͼ11��ʾ�ż���������Qg�������ԡ������Ա�ʾ��������ż���������Qg�������缫-���伫��ĵ�ѹ��VCE�����ż�-���伫��ĵ�ѹ��VGE���仯������“Qg����”��ʾ“IGBT��G-E��ĵ������е�ɱ�����”��һ��Qg��磬VGE��=Qg/C-E����ݣ�������IGBT����ͨ����IGBT��ͨʱ��VCEҲ��֮�½���̬ͨ��ѹ�������������ż�������Qg��ʾ������IGBT����ĵ���������ھ���������·��Դ����ʱ������ø����ԡ�
����ͼ12��ʾIGBT�ĸ�����ݵ����ԡ���ͼ13����ʾ��Cies��ָ�ż�-���伫���������ݣ�Coes��ָ���缫-���伫���������ݣ�Cres��ָ���缫-�ż���ķ�������ݡ������������·ʱ����ʹ���������Ժ�Qg���ԡ�
����4����ȫ��������RBSOA��SCSOA��
����IGBT�ض�ʱ����ȫ������VCE-IC�Ĺ�����Χ��Ϊ����ƫѹ��ȫ��������RBSOA:ReverseBiasSafeOperationArea������ͼ14������ʾ�ķ�Χ������ƻ����·ʱҪ��֤ʹ�ض�ʱVCE-IC�Ĺ����켣ȫ�������ڸ�RBSOA�����ڡ�
������RBSOA��Ϊͨ����������ʱ��ʵ�ߡ��������ʹ��������·��ʱ�����ߡ�������������������Ϊ�����������ʵ���е������ΪRBSOA�������е������ΪSCSOA��ShortCircuitSafeOperationArea��������SCSOA�����ڼ��缫�������ʱ�б�խ��������Ҫ����ע�⡣
����5�����ö����ܣ�FWD������
������IGBTģ���У����ٶ����ܣ��³ƣ�FWD��FreeWheelingDiode����IGBT���������ӣ�������ģ���С���FWD����ͼ15��ʾ��VF-IF���Ժ�ͼ16��ʾ�ķ���ָ����ԣ�trr��Irr�����Լ�ͼ9��ͼ10��ʾ�ķ���ָ�����ʱ������ģ�Err�����ԡ���Щ���Ժ�IGBTͬ�������ڼ���FWD�䷢������ġ����⣬����FWD�������漯�缫�������¶ȡ�RG�����ر仯����Ҫ����ע�⡣
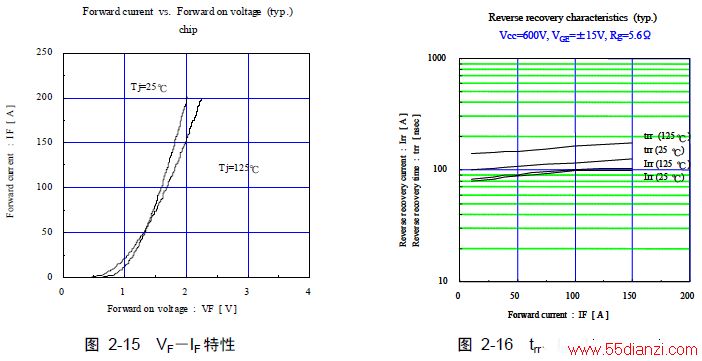
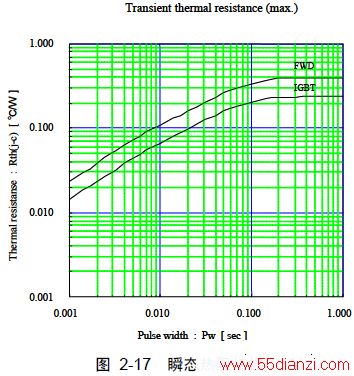
���Ĺؼ��֣�������ϵ��ʽ��·����֪ʶ������ѧϰ - ����֪ʶ - ��·����֪ʶ
��һƪ�������·Ī��������ԭ�����