硅晶片,上电路层的有效厚度一般为几十微米,另外为了保证其功能,需要有一定的支撑厚度,所以,占总厚90%左右的晶片基板是为保证在芯片制造、测试、运送过程中有足够的强度,在电路层制作完成后,对其进行背面削薄,晶片的背面削薄对封装制造过程中的工艺要求极高,一般采用超精密磨削、研磨、抛光等工艺来完成。晶片的厚度越薄,元件导通电阻将越低,信号延迟时间越短,从而实现更高的性能,在音频领域的应用中,进一步提高了音质。另外,晶片越薄,其柔韧性越好,受外力冲击引起的应力也越小。减薄后的芯片可提高热发散效率、机械性能、电气性能、减小芯片封装体积,同时减轻划片加工量并提高成品率。
同时,由于采用了“削薄晶片厚度”工艺,2SA2151/2SC6011以TO-3P的封装获得了与TO-3PL封装同样的大功率输出,最大功率达到160W。其外形封装尺寸见下图。

2SA2151/2SC6011的特性频率为20MHz,直流放大倍数分为3档,用英文字母表示,0为50-100,P为70-140,Y为 90-180。该功率对管的极限参数见附表。从表中可以看出,根据特性参数的不同,对管分为两个档次,分别是普通档和带有字母后缀的“A”档,即2SA2151/2SC6001,“A”档产品的耐压更高一些,可达230V。
极限参数
下图为2SA2151/2SC6001与其它同类功率对管产品的特性比较图,供参考。
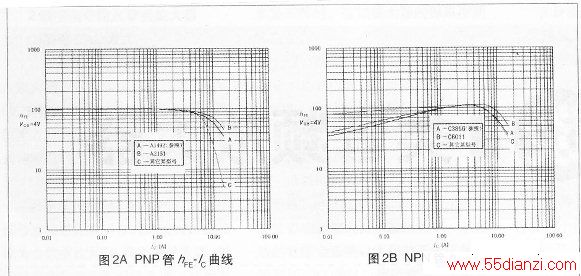
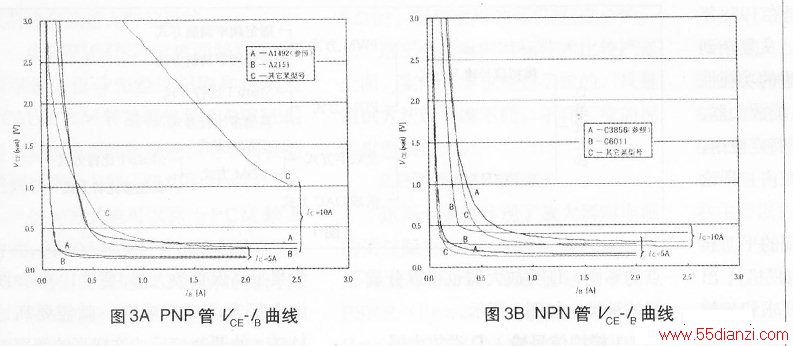
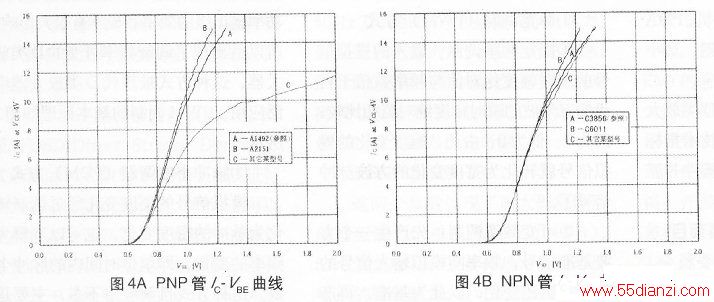

本文关键字:暂无联系方式元器件特点及应用,元器件介绍 - 元器件特点及应用