原子层淀积技术
点击数:7816 次 录入时间:03-04 12:01:37 整理:http://www.55dianzi.com 电子技术
半导体制造中首次大量采用ALD是在动态存储器(DRAM)工艺中。动态存储器的设计尺寸越来越小是为了提高电容密度和减小存储器每一比特的成本。动态存储器设计中要求高纵宽比的沟槽结构,原子层淀积具有这种功能,并能淀积高质量的膜层。用ALD淀积的高k介质能进一步减小EOT,自2000年开始,ALD三氧化二铝(Al2O3)就应用于动态存储器(DRAM)制造中。
最近,Al2O3/HfO2以及Al2O3/ZrO2结构也引起了人们的关注。PEALD也已经用于eDRAM中。电容满足所有的要求,即等效氧化层厚度要小于8埃,125摄氏度时漏电流要小于1fA/cell,工作电压为1伏时寿命要大于十年。图7为典型的ALD薄膜在深槽结构的保角性和动态存储器生产中的半球形硅晶结构,金属ALD薄膜,例如氮化钛(TiN)也广泛应用于动态存储器制造中的电容电极。
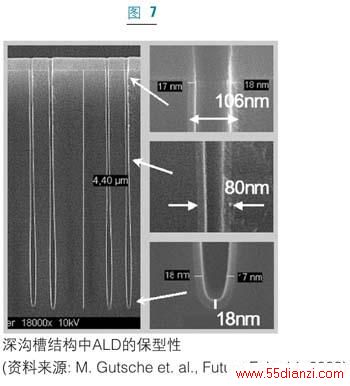
在非挥发性存储器的应用中,人们也开始研究ALD在介质和金属淀积中的应用。闪存技术主要由浮栅(floatinggate)技术主导(图8)。高k电介质目前正被研究作为二氧化硅(SiO2)和氮化硅(Si3N4)栅介质的替代品,以改善浮栅和控制栅之间的电容耦合率。到2010年,浮栅技术可望被一些技术所取代,例如电荷捕获存储器(TANOS,NROM),相变存储器(PCM)、铁电记忆体(存储器),三维堆叠式存储器也正在研究中。ALD已被用作这些技术的阻挡层和扩散阻挡层。
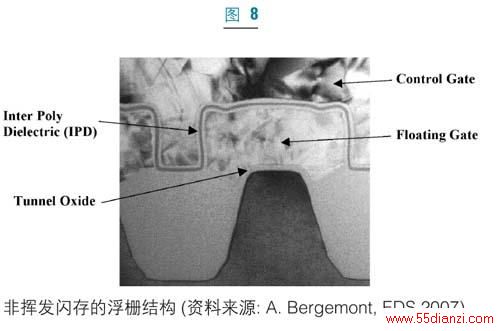
在半导体产业之外,ALD的重要性也今非昔比。ALD氧化铝在制备薄膜磁头(THMH)制造中已经使用了许多年。THMH复杂结构,包括多层薄金属和介质薄膜。ALD薄膜层被用作磁头结构中的带隙介质层和硅片级处理完成后的压缩层。
ALD技术的独特性决定了其在半导体工业中的运用前景十分广泛。器件尺寸的缩小导致的介质薄膜厚度的减小已超出了其物理和电学极限,同时高纵宽比在器件结构中随处可见。由于传统的淀积技术很难满足需求,ALD技术已充分显示了其优势,为器件尺寸的继续微缩提供了更加广阔的空间。
上一页 [1] [2]
本文关键字:技术 电子技术,电工技术 - 电子技术