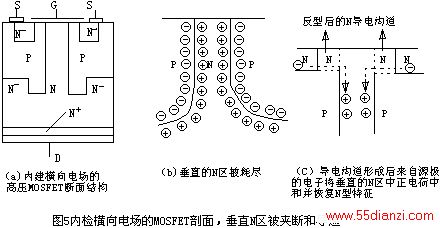
与常规MOSFET结构不同,内建横向电场的MOSFET嵌入垂直P区将垂直导电区域的N区夹在中间,使MOSFET关断时,垂直的P与N之间建立横向电场,并且垂直导电区域的N掺杂浓度高于其外延区N-的掺杂浓度。
当VGS<VTH时,由于被电场反型而产生的N型导电沟道不能形成,并且D,S间加正电压,使MOSFET内部PN结反偏形成耗尽层,并将垂直导电的N区耗尽。这个耗尽层具有纵向高阻断电压,如图5(b)所示,这时器件的耐压取决于P与N-的耐压。因此N-的低掺杂、高电阻率是必需的。
当CGS>VTH时,被电场反型而产生的N型导电沟道形成。源极区的电子通过导电沟道进入被耗尽的垂直的N区中和正电荷,从而恢复被耗尽的N型特性,因此导电沟道形成。由于垂直N区具有较低的电阻率,因而导通电阻较常规MOSFET将明显降低。
通过以上分析可以看到:阻断电压与导通电阻分别在不同的功能区域。将阻断电压与导通电阻功能分开,解决了阻断电压与导通电阻的矛盾,同时也将阻断时的表面PN结转化为掩埋PN结,在相同的N-掺杂浓度时,阻断电压还可进一步提高。
3.2内建横向电场MOSFET的主要特性
3.2.1 导通电阻的降低。INFINEON的内建横向电场的MOSFET,耐压600V和800V,与常规MOSFET器件相比,相同的管芯面积,导通电阻分别下降到常规MOSFET的1/5, 1/10;相同的额定电流,导通电阻分别下降到1/2和约1/3。在额定结温、额定电流条件下,导通电压分别从12.6V,19.1V下降到6.07V,7.5V;导通损耗下降到常规MOSFET的1/2和1/3。由于导通损耗的降低,发热减少,器件相对较凉,故称COOLMOS。
3.2.2 封装的减小和热阻的降低。相同额定电流的COOLMOS的管芯较常规MOSFET减小到1/3和1/4,使封装减小两个管壳规格。
由于COOLMOS管芯厚度仅为常规MOSFET的1/3,使TO-220封装RTHJC从常规1℃/W降到0.6℃/W;额定功率从125W上升到208W,使管芯散热能力提高。
3.2.3 开关特性的改善。COOLMOS的栅极电荷与开关参数均优于常规MOSFET,很明显,由于QG,特别是QGD的减少,使COOLMOS的开关时间约为常规MOSFET的1/2;开关损耗降低约50%。关断时间的下降也与COOLMOS内部低栅极电阻(<1Ω=有关。
3.2.4 抗雪崩击穿能力与SCSOA。目前,新型的MOSFET无一例外地具有抗雪崩击穿能力。COOLMOS同样具有抗雪崩能力。在相同额定电流下,COOLMOS的IAS与ID25℃相同。但由于管芯面积的减小,IAS小于常规MOSFET,而具有相同管芯面积时,IAS和EAS则均大于常规MOSFET。
COOLMOS的最大特点之一就是它具有短路安全工作区(SCSOA),而常规MOS不具备这个特性。COOLMOS的SCSOA的获得主要是由于转移特性的变化和管芯热阻降低。COOLMOS的转移特性如图6所示。从图6可以看到,当VGS>8V时,COOLMOS的漏极电流不再增加,呈恒流状态。特别是在结温升高时,恒流值下降,在最高结温时,约为ID25℃的2倍,即正常工作电流的3-3.5倍。在短路状态下,漏极电流不会因栅极的15V驱动电压而上升到不可容忍的十几倍的ID25℃,使COOLMOS在短路时所耗散的功率限制在350V×2ID25℃,尽可能地减少短路时管芯发热。管芯热阻降低可使管芯产生的热量迅速地散发到管壳,抑制了管芯温度的上升速度。因此,COOLMOS可在正常栅极电压驱动,在0.6VDSS电源电压下承受10ΜS短路冲击,时间间隔大于1S,1000次不损坏,使COOLMOS可像IGBT一样,在短路时得到有效的保护。
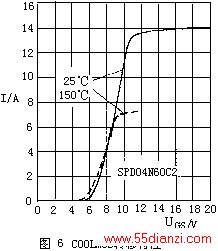
3.3关于内建横向电场高压MOSFET发展现状
继INFINEON1988年推出COOLMOS后,2000年初ST推出500V类似于COOLMOS的内部结构,使500V,12A的MOSFET可封装在TO-220管壳内,导通电阻为0.35Ω,低于IRFP450的0.4Ω,电流额定值与IRFP450相近。IXYS也有使用COOLMOS技术的MOSFET。IR公司也推出了SUPPER220,SUPPER247封装的超级MOSFET,额定电流分别为35A,59A,导通电阻分别为0.082Ω,0.045Ω,150℃时导通压降约4.7V。从综合指标看,这些MOSFET均优于常规MOSFET,并不是因为随管芯面积增加,导通电阻就成比例地下降,因此,可以认为,以上的MOSFET一定存在类似横向电场的特殊结构,可以看到,设法降低高压MOSFET的导通压降已经成为现实,并且必将推动高压MOSFET的应用。
3.4 COOLMOS与IGBT的比较
600V、800V耐压的COOLMOS的高温导通压降分别约6V,7.5V,关断损耗降低1/2,总损耗降低1/2以上,使总损耗为常规MOSFET的40%-50%。常规600V耐压MOSFET导通损耗占总损耗约75%,对应相同总损耗超高速IGBT的平衡点达160KHZ,其中开关损耗占约75%。由于COOLMOS的总损耗降到常规MOSFET的40%-50%,对应的IGBT损耗平衡频率将由160KHZ降到约40KHZ,增加了MOSFET在高压中的应用。
从以上讨论可见,新型高压MOSFET使长期困扰高压MOSFET的导通压降高的问题得到解决;可简化整机设计,如散热器件体积可减少到原40%左右;驱动电路、缓冲电路简化;具备抗雪崩击穿能力和抗短路能力;简化保护电路并使整机可靠性得以提高。
4.功率MOSFET驱动电路
功率MOSFET是电压型驱动器件,没有少数载流子的存贮效应,输入阻抗高,因而开关速度可以很高,驱动功率小,电路简单。但功率MOSFET的极间电容较大,输入电容CISS、输出电容COSS和反馈电容CRSS与极间电容的关系可表述为:
功率MOSFET的栅极输入端相当于一个容性网络,它的工作速度与驱动源内阻抗有关。由于 CISS的存在,静态时栅极驱动电流几乎为零,但在开通和关断动态过程中,仍需要一定的驱动电流。假定开关管饱和导通需要的栅极电压值为VGS,开关管的开通时间TON包括开通延迟时间TD和上升时间TR两部分。
开关管关断过程中,CISS通过ROFF放电,COSS由RL充电,COSS较大,VDS(T)上升较慢,随着VDS(T)上升较慢,随着VDS(T)的升高COSS迅速减小至接近于零时,VDS(T)再迅速上升。
根据以上对功率MOSFET特性的分析,其驱动通常要求:触发脉冲要具有足够快的上升和下降速度;②开通时以低电阻力栅极电容充电,关断时为栅极提供低电阻放电回路,以提高功率MOSFET的开关速度;③为了使功率MOSFET可靠触发导通,触发脉冲电压应高于管子的开启电压,为了防止误导通,在其截止时应提供负的栅源电压;④功率开关管开关时所需驱动电流为栅极电容的充放电电流,功率管极间电容越大,所需电流越大,即带负载能力越大。
4.1几种MOSFET驱动电路介绍及分析
4.1.1不隔离的互补驱动电路。图7(a)为常用的小功率驱动电路,简单可靠成本低。适用于不要求隔离的小功率开关设备。图7(b)所示驱动电路开关速度很快,驱动能力强,为防止两个MOSFET管直通,通常串接一个0.5~1Ω小电阻用于限流,该电路适用于不要求隔离的中功率开关设备。这两种电路特点是结构简单。

功率MOSFET属于电压型控制器件,只要栅极和源极之间施加的电压超过其阀值电压就会导通。由于MOSFET存在结电容,关断时其漏源两端电压的突然上升将会通过结电容在栅源两端产生干扰电压。常用的互补驱动电路的关断回路阻抗小,关断速度较快,但它不能提供负压,故抗干扰性较差。为了提高电路的抗干扰性,可在此种驱动电路的基础上增加一级有V1、V2、R组成的电路,产生一个负压,电路原理图如图8所示。

当V1导通时,V2关断,两个MOSFET中的上管的栅、源极放电,下管的栅、源极充电,即上管关断,下管导通,则被驱动的功率管关断;反之V1关断时,V2导通,上管导通,下管关断,使驱动的管子导通。因为上下两个管子的栅、源极通过不同的回路充放电,包含有V2的回路,由于V2会不断退出饱和直至关断,所以对于S1而言导通比关断要慢,对于S2而言导通比关断要快,所以两管发热程度也不完全一样,S1比S2发热严重。
该驱动电路的缺点是需要双电源,且由于R的取值不能过大,否则会使V1深度饱和,影响关断速度,所以R上会有一定的损耗。
4.1.2隔离的驱动电路
(1)正激式驱动电路。电路原理如图9(a)所示,N3为去磁绕组,S2为所驱动的功率管。R2为防止功率管栅极、源极端电压振荡的一个阻尼电阻。因不要求漏感较小,且从速度方面考虑,一般R2较小,故在分析中忽略不计。
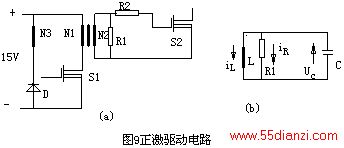
其等效电路图如图9(b)所示脉冲不要求的副边并联一电阻R1,它做为正激变换器的假负载,用于消除关断期间输出电压发生振荡而误导通。同时它还可以作为功率MOSFET关断时的能量泄放回路。该驱动电路的导通速度主要与被驱动的S2栅极、源极等效输入电容的大小、S1的驱动信号的速度以及S1所能提供的电流大小有关。由仿真及分析可知,占空比D越小、R1越大、L越大,磁化电流越小,U1值越小,关断速度越慢。该电路具有以下优点:
本文关键字:如何 电子技术,电工技术 - 电子技术